리우 회장, “패키징 병목이 제조 발목” 지적
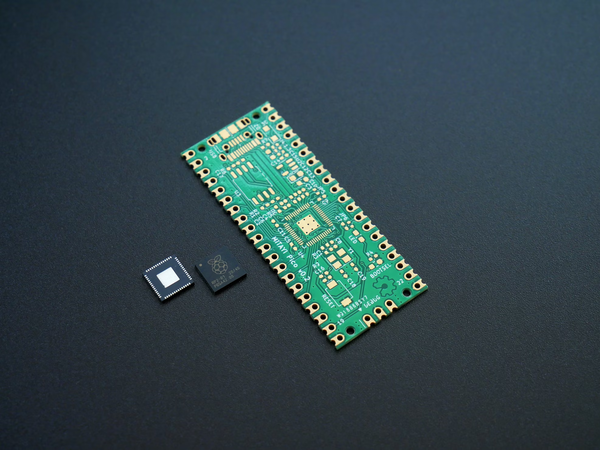
“반도체 공급 부족은 2024년 말까지 간다.”
기술매체 더 레지스터(The Register)은 마크 리우 TSMC 회장이 “반도체 제조의 최종 공정인 ‘패키징’의 병목현상으로 인해 반도체 제조가 크게 지연되고 있다”면서 이 같이 밝혔다고 보도했다. 특히 인공지능(AI)에 최적화된 광대역폭 제품에 미치는 영향이 클 것으로 보인다고 한다.
리우 TSMC 회장은 자사의 ‘CoWoS(칩 온 웨이퍼 온 서브스트레이트)’ 패키징 기술이 수요의 약 80%만 충족할 수 있으며, 이 기술을 적용한 최첨단 칩 중 일부, 특히 AI에 최적화된 ‘NVIDIA H 100’ 등 광대역폭 메모리용 칩의 생산이 크게 지연되고 있다고 밝혔다.
엔비디아 H100은 4만 달러(한화 약 5200만 원)에 달하는 고성능 GPU로, 특히 대규모 언어모델(LLM)을 비롯한 생성 형 AI가 필요로 하는 높은 컴퓨팅 능력을 충족시키는 역할을 담당하고 있다. 이 제품은 2022년 3월에 발표됐는데, 일부 서버 제조업체는 입하까지 6개월 이상 기다려야 한다고 밝혔다.
리우 회장은 CoWoS 수요가 지난 1년간 3배 가까이 증가해 당분간 공급 부족이 지속되겠지만, 2023년 9월부터 18개월 이내에 공급 부족이 해소될 것으로 예상했다.
TSMC는 타이완 먀오리 현에 30억 달러(약 4조 원) 규모의 시설을 건설해 패키징 능력을 확대할 계획을 발표했다. 또한 CoWoS의 새로운 기술인 ‘CoWoS-L’을 발표해 기존보다 최대 6배 큰 칩을 생산할 계획을 세웠다.
관련기사
김태훈 기자
hoon@techdaily.co.kr

